微机电(MEMS)、奈米技术、半导体晶圆接合暨微影技术设备厂商EV Group(EVG)宣布该公司的全自动12吋(300mm)使用聚合物黏着剂的晶圆接合系统目前市场的需求非常强烈,在过去12个月以来,EVG晶圆接合系列产品包含EVG560、GEMINI及EVG850 TB/DB等订单量增加了一倍,主要来自于晶圆代工厂以及总部设置于亚洲的半导体封测厂(outsourced semiconductor assembly and test;OSAT)多台的订单。而大部份订单需求的成长受到先进封装应用挹注,制造业者正加速生产CMOS影像感测器以及结合2.5D和3D-IC矽穿孔(TSV)互连技术的垂直堆叠半导体。
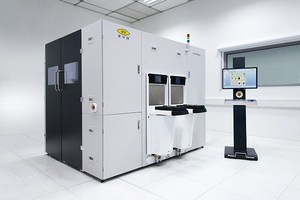 |
| EVG560全自动晶圆接合系统可配置多达四个接合腔体,可应用在各种不同的晶圆接合制程,包含阳极处理、热压、熔融接合、低温电浆接合等,且可处理的晶圆尺寸可达12吋(300mm直径) |
根据市场研究及策略咨询机构Yole Developpement研究指出,针对3D-IC以及晶圆级封装(wafer-level packaging;WLP)应用的设备市场将有显著成长,预期总营收将从2014年的9.33亿美元成长到2019年的26亿美元,年复合成长率在接下来的五年将达19%*,而使用聚合物黏着剂的晶圆接合技术在支援这些应用中扮演不可或缺的角色。
使用聚合物黏着剂的全自动晶圆接合技术提升堆叠元件之良率
使用聚合物黏着剂的晶圆接合是使用中间层(通常是一种聚合物)的技术来接合两块基板,该制程技术对于先进封装应用十分重要。采用此方法的主要优势包含低温制程、表面平坦化以及晶圆图案结构的高低容差。针对CMOS影像感测器应用,使用聚合物黏着剂的接合技术为影像感测器表面和覆盖的玻璃晶圆之间提供一道保护屏障。而在3D-IC TSV应用上,此接合技术在暂时接合(temporary bonding)以及剥离(debonding)应用上扮演着重要的角色,其中产品晶圆能藉由有机黏着剂暂时安置于载具上,以实现可靠的薄化与后段制程。
对于CMOS影像感测器以及堆叠记忆体/逻辑应用,完全自动化晶圆接合解决方案尤其重要,其能支援制造业者转移至更大(12吋)的晶圆基板以降低总生产成本。举例来说,将总厚度变异(total thickness variation;TTV)最小化是决定最终产品厚度公差的关键,且最终将对实现更薄的晶圆及元件有所影响,进而达到更高的互连密度及更低的TSV整合成本。EVG全自动晶圆接合系统透过重复晶圆到晶圆(wafer-to-wafer)制程和整合内建的量测装置,为总厚度变异及其他参数作优化控制,因此制造业者也日益转移至EVG ,以支援其全自动晶圆接合的需求。
EVG销售暨客户支援执行董事Hermann Waltl表示:「我们已真正进入3D-IC的世代,TSV晶圆的需求在多个领域正在增长,包含智慧型手机相机与车用环绕影像所需的CMOS影像感测器,到支援网路、电竞、资料中心与行动运算等高效能、高频宽应用的3D堆叠记忆体和memory-on-logic。对于CMOS影像感测与半导体元件制造业者而言,全自动化晶圆接合是支援以上应用量产需求的关键制程。EVG累积了多年研发晶圆接合技术的经验,使其成为先进封装市场重要的、有附加价值的解决方案。 」(编辑部陈复霞整理)
[参展讯息]
展会名称:SEMICON TAIWAN 2015
展会日期:9月2 ~4日
参展厂商:EV Group
参展地点:南港展览馆
摊位编号:706