蔡司(ZEISS)今日發表高解析度3D X光(X-ray)成像解決方案新品,支援2.5/ 3D及扇出型晶圓級封裝(FOWLP)等各種先進半導體封裝的失效分析(FA)。蔡司新推出的系統包含分別支援次微米與奈米級封裝失效分析的「Xradia 600 Versa系列」、「Xradia 800 Ultra X-ray顯微鏡(XRM)」及新款「Xradia Context microCT」。
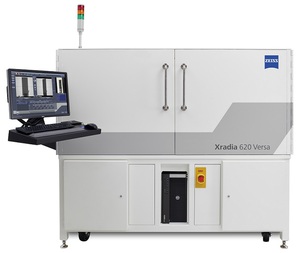 |
| 蔡司針對先進半導體封裝失效分析推出全新3D X-ray成像解決方案 |
蔡司製程控制解決方案(PCS)暨蔡司半導體(Carl Zeiss SMT)總裁Raj Jammy表示:「170年來,蔡司持續拓展科學研究並開發先進的成像技術,以促成嶄新的工業應用與技術創新。現今半導體產業的封裝與元件體積持續縮小,因此新的成像解決方案必須迅速辨識出失效的元件區域以達到更高的封裝良率。我們非常高興能針對先進半導體封裝推出三款全新的3D X-ray成像解決方案,為客戶提供強大的高解析度工具,並提高其失效分析的成功率。」
隨著半導體產業逐漸逼近CMOS微小化的極限,半導體封裝必須協助彌補效能上的落差。為持續生產體積不斷縮小且速度更快的元件,並滿足更低功耗的需求,半導體業界透過3D晶片堆疊及其他新穎的封裝規格,發展出創新的封裝方法。然而,這也衍生出日趨複雜的封裝架構、新的製程挑戰以及日漸升高的封裝失效風險。此外,由於失效的位置通常深藏在複雜的3D結構內部,傳統的視覺化失效定位方法已逐漸失去效益,因此新的檢測方式必須能有效辨識並判定這些先進封裝失效的原因。
為因應這些需求,蔡司開發出全新的3D X-ray成像解決方案,能針對埋藏在完整的先進封裝3D架構中的電路板與其缺陷,呈現次微米與奈米級的3D影像。此解決方案是透過旋轉樣本,以不同的角度拍攝一連串2D X-ray平面影像,再運用精密的數學模型與演算法建構出3D立體圖像。3D立體圖可從任何角度切分成數量無上限的虛擬橫切面視圖,在進行物理失效分析(PFA)之前提供失效位置的寶貴資訊。蔡司所提供的次微米與奈米級結合的XRM解決方案能提供獨特的FA工作流程並大幅提高其成功率。