近年來,隨著全球電信自由化潮流及技術日益成熟,無線通訊產業趨於活絡而使產品類別更多元化,其應用層面包栝傳統的家用無線電話、無線區域網路(Wireless LAN)、個人無線通訊系統及最熱門的藍芽無線技術(Bluetooth)等。而整個無線通訊系統中射頻功率放大器是非常重要的關鍵性元件,因為它的輸出功率決定了通訊距離的長短,它的使用效率決定了電池的消耗與使用時間。因此,功率放大器將是業界研發的重點。
行動電話的零組件與基本運作模式
一具完整的數位式手機具備外觀看得見的按鍵、液晶顯示、機構外殼、識別卡(SIM)機構,以及內部的功能。(圖一)簡單畫出數位式手機內部的功能方塊圖;由於晶片不斷整合的結果,手機的功能方塊可粗略分為射頻(RF,Radio Frequency)、中頻(IF,Intermediate Frequency)和數位基頻(BB,Digital Baseband)三部分;但由於技術的演進,一些業者發展出直接轉換技術(Direct Convert)或稱零中頻(Zero IF),直接由射頻降頻轉換基頻可處理的訊號。
以整體的系統而言,射頻部份電路約佔整體成本的三至五成,其主要的零組件包含功率放大器(PA;Power Amplifier)、低雜訊放大器(LNA,Low Noise Amplifier)、傳送/接收器、合成器、頻率多工器(Diplexer)、多工器(Duplexer)、表面聲波濾波器(SAW filter)及TR Switch等功能;中頻部份有AD/DA調變與解調器、鎖相迴路(PLL)、電壓控制震盪器(VCO)、表面聲波濾波器(Saw Filter)等;基頻部份有數位訊號處理器(DSP)、微控制器(MCU)和記憶體(Flash、SRAM)等。
和無線訊號傳送接收有直接關聯者為射頻IC。射頻IC讓該通訊產品能夠以射頻頻帶(900Hz~3GHz)傳輸和接收數據或語音等資訊。在接收的程序上,射頻與中頻IC將來自天線的訊號,經過放大、射頻與中頻濾波、合成等功能,將接收到的射頻訊號,經一次或兩次降頻為基頻,以便接下來的基頻訊號處理。發射時,射頻與中頻IC將上述過程反向程序操作;將低頻訊號在基頻區域經多次升頻之後轉換成射頻的頻率經由天線發射出去,因此射頻電路須具備良好的接收特性和抗雜訊干擾的能力。
射頻與中頻IC在數位式行動電話中所佔的功能方塊,包含調變器、頻率合成器、升降頻轉換和功率放大器等等,大約消耗手機約六成的功率。射頻與中頻模組主要的功能是接收射頻訊號,將訊號降頻至基頻,以便處理;發射時,則將基頻傳來的訊號升高到射頻,以便發射。早期射頻電路幾乎全部都是分離式元件,之後才逐漸整合成至單一晶片。大部分的行動電話使用三顆IC在射頻系統 電路,包括一顆整合的射頻訊號接收與發射器晶片、一顆IF元件和一顆RF功率放大器。除了IC之外,還包括上百顆被動元件和分離式元件,佔了手機的大部份空間,所以如何將這些被動元件整合是業者努力的方向。
目前各大行動電話發展趨勢朝向複合化前進,複合化包括多頻與多模兩種形式。所謂的雙頻(三頻)手機或多頻手機,就是同一手機可接收多種頻率區域的訊號,如900MHz、1800MHz與1900MHz不同頻帶。而多模的意思是一隻手機可同時接收兩種或兩種以上的通訊系統,如日本同一手機上,可接收簡易式行動話(PHS)及PDC兩種通訊系統的服務,美國則可同時接收數位行動系統訊號與類比訊號,這就是一種多模的應用。由於手機朝多頻、多模的方向發展情況下,使得每隻手機內所需的RF零件,需求量也隨之增加,其中以功率放大器(PA,Power Amplifier)及表面聲波濾波器(SAW Filter)最明顯。
功率放大器負責提供整個手機在發射與接收時的運作功率,在整個數位手機中屬於相當重要的線性IC,評估一個放大器的性能,尤其是在接收的系統電路中,通常會以檢視其處理微弱訊號的能力,作為判定性能優劣的依據,若放大電路處理小信號能力強,其在抑制或消除雜訊的能力也愈強。
另外使用者評估手機除了通訊品質,還有一項重點是通話與待機時間,而功率放大器是整個發射端最耗電的組件,大部份的功率消耗在此電路中,因此,功率放大器的設計與製造是非常重要的一項工作。任何無線通訊產品要將訊號發射出去,都透過電路最後一級的功率放大器,因此,功率放大器可以依不同的需求,例如操作頻率、頻寬、供應電壓、輸出功率、效率及放大器操作類別適用在不同的通訊產品上。
行動電話內部元件組裝趨勢
輕薄短小的體積要求下,手機IC朝單晶片與模組化趨勢發展,目前以基頻IC的整合性最積極,以往各別由記憶體、微處理器和DSP主要元件組成的基頻電路,演進為DSP與微處理器整合,目前也完成將部分SRAM嵌入晶片中,使得手機元件分成射頻晶片與基頻晶片兩塊,這將減化手機設計的困難度。
依目前行動電話整合趨於來看,未來手機中IC數量將可能減少到9或8顆,其中射頻IC為2至3顆,基頻IC約1至2顆,語音、影像或藍芽等1至2顆數位或混和訊號處理器,1至2顆記憶體晶片。先進的混和訊號製程技術、SoC設計經驗與電路模組化整合能力,這些都是想成功進入手機市場的關鍵。雖然手機IC整合趨勢相當確定,但是無法達到製造成本效益也是枉然。
行動電話之輕薄短小仍是發展的趨勢,整合型被動元件、複合元件、單晶片通訊模組等概念,已在市場成為新的發展方向。為達到壓縮零組件所佔空間、避免電磁波干擾(EMI)問題及PA會因為高頻產生高溫,唯有選擇正確的電路構裝方式或具有模組化技術,才能達到模組小型化的目標。由於行動電話重量及厚度的下降,相關的零組件無論在重量、體積、性能都要做相當的提升,未來行動電話用的印刷電路板仍朝更輕、更小的高密度方向發展,且每台手機上將來用到的IC數目會比現在少很多。(圖二)為行動電話的零組件及組裝的分類及所使用的封裝方式。
目前已有廠商研發積層式樹脂材料基板,兼具降低產品成本與小型化的特色。以樹脂加上介質及磁性物質混合成基板材料,與多層陶瓷基板堆疊元件技術相比,在材料方面成本似乎較為低廉,良率也較高。若採用樹脂方式時,可以將不同介電率的樹脂堆疊在一起,此應用性更為廣泛。
在整合性模組技術方面,目前有幾種作法,包括目前一般的印刷電路板、增層式印刷電路板以及模組(Module)基板等方式。現在模組(Module)基板常使用三種材質:陶瓷、低溫共燒(LTCC,Low Temperature Cofired Ceramics)、塑膠薄板(Laminate)。以整合性模組技術的發展來看,目前以低溫共燒陶瓷技術(LTCC)、整合式被動零組件技術(IPD,Integrated Passive Devices)及增層式印刷電路板的薄膜技術(Thin Film)等方式。

| 《圖二 行動電話的零組件及組裝的分類〈資料來源:Amkor, Fujitsu, Prismark, Conexant, TechSearch〉》 |
|
功率放大器的特性
無線通訊正是現今熱門的重點科技領域,無論在個人手機或基地台通訊系統方面,前端之射頻電路模組扮演相當重要的角色,而功率放大器更是射頻模組中之關鍵元件,功率放大器的線性度、輸出功率以及效率深深影響著無線系統中的訊號品質、通訊距離以及待機時間。
基本放大器之設計包括大訊號功率負載相關參數的取得、直流偏壓電路以及匹配網路設計等,而每一項都攸關功率放大器製作之成敗。另外放大器設計的功率愈來愈大,因此散熱也成為設計的重點之一。
(圖三)為一個簡單的電晶體放大電路,包括直流電晶體偏壓電路;電感與電容組成的匹配網路設計。電晶體偏壓電路是為了建立良好的工作點,提供電晶體放大的能量,並能隔離DC與AC訊號,因此,一電路的穩定性與其偏壓電路有很大的關係。直流偏壓的選擇與放大器的用途(如低雜訊、高增益、高功率等)、放大器的類別(如A類、B類、AB類)及電晶體的種類(如BJT、FET)相關。
電晶體兩旁的匹配網路,分為輸入匹配網路與輸出匹配網路,由電感器與電容器組成,具有調整輸入阻抗、輸出阻抗與選擇頻率的濾波功能,調整輸入阻抗與輸出阻抗使輸入及輸出達到最大的功率傳輸。
但基本放大器和功率放大器的設計觀點有所不同,基本放大器都是利用小訊號來設計,且工作在電晶體的線性區內,所以設計的考量在訊號的增益方面。但功率放大器的目的在於獲得最大輸出功率,使得電晶體工作在趨近飽和區,無論輸入功率如何變動,功率放大器的輸出功率只會維持在一個飽和區的位準。
在PC時代,半導體製程主要以矽(Si)製程為主,經過長時間的研究發展,使其具有製程技術成熟、元件穩定度高、易於生產、低成本、具高度整合性等特色,再加上原料成本較低,而成為大部分積體電路使用的製程材料。早期類比式的800/900MHz行動電話,要求頻率與線性度標準較低,大部份RF元件仍可由矽製程的BiCMOS技術來製作。但目前的數位行動電話GSM、CDMA的RF元件中要求的元件需具備高頻、線性效果佳、高效率、低雜訊等效果,因此,矽製程由於先天特性上的問題,對於無線通訊所要求的高頻化,己無法勝任,也使得砷化鎵製程找到發揮的空間。
目前功率放大器所使用的材料有砷化鎵(GaAs)、矽鍺(SiGe)等,但隨著無線通訊高頻化的要求,採用異質接面雙極電晶體(HBT)製程與砷化鎵材料的半導體元件逐漸成為主流。砷化鎵以其材料本質上的優勢,在高頻響應特性良好,雜訊值低、效率高、增益值大、線性度佳,又可做成單晶微波積體電路功率放大器(MMIC PA)等特性下,在無線通訊領域的應用逐漸增加。
功率放大器之封裝模組化
PA module組裝的關鍵技術在於PA module沒有標準,必須配合IC公司的設計,形狀包裝多樣,也就是非常客製化,甚至測試程式也非常不同。
另外手機朝多頻、多模方向發展的情況下,使得每隻行動電話內可能包含多個不同頻率或模式的功率放大器,因此使得功率放大器的分類更為複雜。
以往在行動電話功率放大器部份,是採用分離式元件(Discrete)進行組裝,但在阻抗的匹配問題上,會有微調(Tune)的困難,因此,有些PA晶片廠商會設計功率放大器模組,將功率放大器(PA)晶片與幾個被動元件封裝一起,提供輸出與輸入端達50歐姆的阻抗匹配電路,除了使產品在高頻訊號更?定,還能大幅減少無線通訊產品所需之外部元件。模組化設計只是初步,最後終將整合為單一系統化的封裝(SiP)結構發展,採用SiP設計的好處︰IC公司已經為下游系統客戶解決了部份的相容問題,且SiP會讓產品體積小,縮短設計時間,符合time to market的重點,也省成本。
電子系統之輕薄短小趨勢,市場對多晶片模組封裝 (MCM)的需求與日俱增,行動用功率放大器 (PA)模組及藍芽 (Bluetooth)模組皆是未來趨勢,GPRS 功率放大器、藍芽模組之整合構裝及光電通訊之發射及接收模組皆是未來發展重點。
功率放大器之封裝的電性寄生效應
由於封裝的寄生效應相當於產生一組電感、電容、電阻的等效寄生電路,此封裝的寄生電路將改變功率放大器原設計的抗匹配網路,使得輸入阻抗與輸出阻抗改變,造成電路阻抗無法匹配降低功率傳輸與操作頻率飄移的現象。
因此設計高頻元件的封裝時,對於元件之高頻特性需詳加分析,最好能透過實際測量建立各別封裝電性參數資料庫,以提高電路模擬之準確度。
分析一個利用導線架的封裝方式,如目前商用的包裝如LCC、SSOP、SOIC、TSOP,其完整信號傳遞路徑包括:晶片與導線架的金線連接、導線架的線路、導線架至PCB的引腳長度,其接腳電感加上打線電感約2 nH至6 nH左右,若RF IC之設計在3 GHz以下,考慮封裝雜散效應,使用導線架的封裝方式仍然可以正常操作,在進入4 GHz以上,匹配電路的電感值將接近這個範圍,因此封裝將勢必成為設計的一部分。
BGA的封裝方式則將導線架引腳改為BGA鍚球陣列的方式,並且鍚球直接設計在晶片的下方,可大大降低封裝體積,也縮短導體線路的距離。但連接晶片與封裝基板的連接,仍採用打線連接的方式,因為金線連接兩者仍有一段距離且金線本身相當細,因此含有相當大的寄生電感參數。若將此連接的方式再改為覆晶接合(Flip-Chip),以覆晶凸塊連接晶片與封裝基板,對電氣特性的效能也會有所幫助。覆晶的特色是以凸塊連接晶片與基板,不過使用凸塊有許多因應力而造成可靠度不佳的現象,業界於是想到於凸塊間灌入底膠(Underfill)來改善。但是,灌入底膠其程序相當繁瑣,再加上封裝後成本的始終居高不下,是目前覆晶封裝所面臨到的瓶頸。
另一種無凸塊式覆晶技術(Bumpless Flip-Chip)的連接方式,一樣沒有打線方式的金線長度,也減少了覆晶凸塊的高度,晶片與封裝導體幾近直接連接在一起,目前已有Intel推出的BBUL及鈺橋的B2 Technology。因此,除了在電氣特性的效能會有更明顯的改善外,也符合未來產品走向輕、薄、短、小的趨勢。
嵌入式被動元件與MEMS元件的發展
一種關於被動元件整合的熱門話題,就是所謂的嵌入式被動元件(Embedded Passives)技術,目前的技術分別有:陶瓷基材的低溫共燒技術(LTCC)、有機(Organic)基板配合高介電系數的介電層材料或利用嵌入式高分子厚膜等的方法,將系統所需要的被動元件整合在封裝基板內,達到系統化封裝的需求。嵌入式被動元件的優點除了減少被動元件佔用的基板表層面積,以及將被動元件更加接近主動元件外,由於無被動元件的封裝接腳所產生的寄生效應,因此電氣特性在高頻訊號的表現上更穩定。
另外有別於將被動元件整合在基板的技術,是將被動元件直接製作在晶片中,但目前積體電路製作以矽作為底材的CMOS製程,所謂的低Q值一直是為人所攻擊,因為高頻時由於受到基板寄生效應影響,Q值皆小於10,但為了維持高信號/噪音比,所以組成元件最好能具有高Q值以避免信號損耗,但這個缺點在微機電(MEMS)技術的參與發展下,將使行動電話整合單晶片的實現成為可能。如(圖四)為利用MEMS所製作的電容器被動元件,具有電容值可調整的功能,利用覆晶(Flip-Chip)方式整合至封裝基板上的例子。

| 《圖四 MEMS所製作的可調式電容器被動元件與覆晶封裝方式〈資料來源:IEEE Paper〉》 |
|
功率放大器之散熱問題
近年來功率電晶體體積愈來愈小,而輸出功率愈來愈大,熱量容易累積而使功率電晶體容易因高溫受損。為了提升電晶體工作的可靠度,在設計功率放大器時,除了要求高功率放大性能之外,對於散熱的要求也是封裝設計的重點。
功率電晶體的散熱效應,決定於電晶體的熱阻抗(Thermal Resistance),使用散熱片能確保元件的接面溫度(Junction Temperature)在最大值以下,散熱片的尺寸決定於散熱片的材料、電晶體功率消耗、散熱片周圍的通風、與操作時周遭的溫度,通常元件直接附著在散熱片上,如此可增加散熱的效率。晶片與散熱片之間的熱傳導通道愈短愈好,且應為良好之熱導體,例如鋁材。在外型設計上,採用散熱面積較大的散熱片將能增加散熱的效果。
另外可採用覆晶接合(Flip-Chip)方式與陣列錫球(BGA)的引腳方式,這兩種方式可以彈性的在晶片下方設計熱傳導球(Thermal Ball) ,直接將熱由錫球引導出去,增加封裝散熱途徑。
國外廠商之功率放大器發展狀況
目前行動電話的功率放大器中,由於前四大廠商:RF MD、Hitachi、Conexant與Motorola已掌握近七成的市場,市場寡占的情形相當明顯,其中北美廠商即擁有超過一半的市場佔有率。全球佔有率近20%的RF MD,以供應Nokia為主,因此產品多為GSM系統所使用;排名第二的Hitachi則以供應日製手機為主;緊追在後的有Conexant與Motorola,Conexant以量產CDMA系統為主,主要供應Ericsson與Samsung使用,而Motorola則是以供應自製行動電話為優先,不足的部分則向Conexant採購。
功率放大器是半導體產業中相當奇特的一部分,在全球矽半導體走向垂直分工的情形下,生產功率放大器的廠商大多不為所動(包括Si PA與GaAs PA在內的廠商),仍是一手包辦設計、IC製造、封裝、測試等。有些廠商甚至連磊晶片都自己量產,RF MD就是一例,而Conexant則算是功率放大器產業中最早走向垂直分工的廠商,將功率放大器的砷化鎵IC製造分成:砷化鎵磊晶製造、IC設計、IC代工、封裝與測試,目前Conexant將磊晶交給全新;將代工交給博達;封裝、測試、模組部分亦已委由其他廠商來執行。
目前大廠之功率放大器封裝方式介紹
Conexant針對全球各個主要無線通訊標準,包括寬頻分碼多重存取(WCDMA)、多頻式全球行動通訊(GSM)、分碼多重存取(CDMA)、動態分時多重存取(TDMA)、先進行動電話系統(AMPS)及無線區域迴路應用提供了涵括各式解決方案之廣泛的功率放大器產品,並且大量組合多個不同頻率或模式的功率放大器於單一封裝設計,即所謂多晶片模組封裝(MCM)產品。(圖五)為Conexant所使用的MCM封裝(稱為Micromodule package)的尺寸及外觀圖。
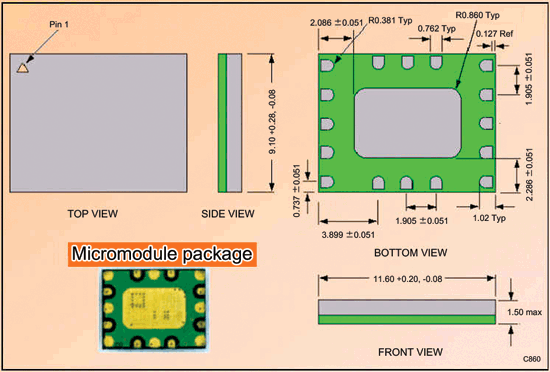
| 《圖五 Micromodule Package的尺寸及外觀圖〈資料來源:Conexant公司〉》 |
|
Maxim公司推出MAX2242線性功率放大器,適用於2.4GHz ISM-Band無線區域網路相關產品,如IEEE802.11b、Wireless LANs、Home PF、2.4GHz Cordless Phones、2.4GHz ISM radios,此功率放大器採用超小型晶片級包裝(UCSP:Ultra-Chip-Scale Package),面積只有1.5mm × 2.0mm (圖六),因此適用於PC Card型式的無線區域網路(Wireless LAN)產品。UCSP封裝除了有體積小的優點外,因為無金線連接晶片與封裝基材,可降低晶片與電路板之間的電感雜散效應,因而提升射頻(RF)訊號的效能。
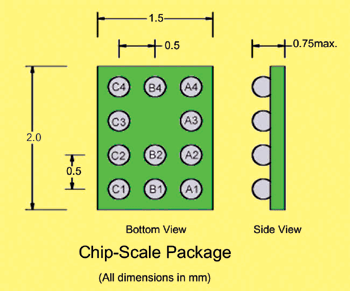
| 《圖六 3 x 4 UCSP封裝的尺寸圖〈資料來源:Maxim公司〉》 |
|
結論
在無線通訊的環境下,發射機的發射訊號對其他使用者可能是一種干擾,這現象稱為EMI干擾;同樣的,接收機也會受到其他人為或自然訊號源的干擾,稱為EMC防干擾能力,即使是所欲接收的訊號,也會由於訊號的多重路徑(multi-path)傳播、建築物的遮蔽(Shadowing)效應,以及元件的非線性特性產生的失真與量化雜訊,造成訊號還原時的解調困難。而現今系統都朝數位化發展,對訊號品質都有一定的要求,因此在整體射頻?組的整合過程中,除了掌握整體性能與各元件的適合性外,還要克服元件封裝雜散效應所造成的EMI或EMC干擾及與晶片的匹配問題,所以模組化的設計與選用的封裝適當與否將是影響成敗的關鍵。
隨著無線通訊產品的薘勃發展與系統之輕薄短小的趨勢,市場對模組化封裝與高效能的封裝技術需求與日俱增,功率放大器是目前無線通訊電路中之核心元件,具有最高的附加價值,厥為最佳之研發領域。
(本文作者任職於鈺橋半導體)