現階段國內封測產業,雖針對市場上不同的應用產品發展出各式各樣的封裝型態,但實際作為晶粒與外界電路連接的方法,僅有銲線(wire bonding)、捲帶式自動接合(TAB)以及覆晶(flip chip)三種封裝技術。其中銲線封裝,為目前最主要的產品採用技術;捲帶式自動接合技術,其應用範圍較為有限,主要在薄膜電晶體顯示面板(TFT LCD)的產品使用。至於近年來極受矚目的覆晶封裝技術,雖然目前僅佔總產能的5%以下,但預計在2005年後便可望超越銲線封裝成為市場主流,也因此吸引了許多國內外的封裝業者投入研究及開發相關技術。
根據市場調查機構TechSearch所做的調查資料顯示,全球採用覆晶封裝技術的晶片出貨量於2001時僅10億多顆,但預估至2003年將倍增到20多億顆,2005年更可突破35億顆,顯見覆晶技術的高度發展潛力與成長速度,並充分點出覆晶技術在所有封裝型態中的重要性。
覆晶封裝技術發展背景
覆晶封裝技術始於1960年代,當時IBM為了大型電腦的組裝,而開發出了所謂的C4(Controlled Collapse Chip Connection)技術,隨後進一步發展成可以利用熔融凸塊的表面張力來支撐晶片的重量及控制凸塊的高度,並成為覆晶技術的發展概念。
所謂的覆晶封裝技術,即是指將晶粒(Die)之接合墊上生成錫鉛凸塊(solder bump),而於基板上的接點與晶片上凸塊相對應,接著將翻轉之晶粒對準基板上之接點放置於基板上,經由迴銲(reflow)製程將凸塊融化,待凸塊冷卻凝固之後,便形成晶片與基板之間的信號傳輸通路。
這樣的封裝型態將可符合新興的電子產品在效能表現提高及體積小型化的發展需求,因而逐漸受到重視;如(圖一)。
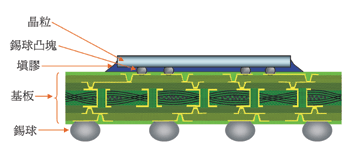
| 《圖一 Flip chip BGA切面圖〈資料來源:圖片提供:日月光〉》 |
|
覆晶封裝技術之優勢與應用趨勢
重要性與優勢
1.解決電磁相容(EMC)與電磁干擾(EMI)等問題
當電子產品功能日益提升,而電壓卻被要求降低時,IC設計人員便面臨了如何控管晶片內晶體耗電量,以及解決電磁相容(EMC)與電磁干擾(EMI)和串音干擾(cross talk)等問題。一般而言,採用銲線封裝技術的晶片,其信號傳遞是透過具有一定長度的金線來進行,這種方法在高頻的情況下,會產生所謂的阻抗效應,形成信號行進路線上的一個障礙;但覆晶技術可以提供最短的對外連接距離,不僅提供優異的電性效能,同時可以減少元件互連間的損耗及電感,降低電磁干擾的問題,並承受較高的頻率。
2.適用於1000組以上I/O的裝置
當IC設計人員在相同的矽晶區域中嵌入越來越密集的電路時,I/O與針腳的數量就會迅速增加,而覆晶技術的另一項優勢是可提高I/O的密度。一般而言,採用銲線技術的I/O接腳都是排列在晶粒的四周,但採用覆晶技術,I/O接腳可以陣列的方式排列在晶粒的表面,提供更高密度的I/O佈局,產生最佳的使用效率,也因為這項優勢,覆晶技術相較於傳統封裝方式面積縮小30﹪到60﹪,提高單一晶圓的晶粒產出數,進而大幅降低成本。因此,覆晶技術在需要細間距的I/O需求之晶片上,即擁有特別的應用優勢,對於許多超過1000組以上I/O的裝置,覆晶技術已成為最優先的選擇。
(3)散熱問題獲得解決
在各種新世代的高時脈運作與高度整合之晶片中,散熱問題亦是一大挑戰。基於覆晶封裝獨特的封裝型態,採用覆晶技術的IC之背面可接觸到空氣,能直接排散熱量,同時基板亦可透過金屬層來提高散熱效率,或於IC背部加裝金屬散熱片,更進一步強化晶粒散熱的能力。
應用趨勢
覆晶封裝技術由於具備優越的電性效能、直接散熱管道及更小的封裝尺寸等特性,因此適用於高速元件,目前最常應用於中央處理器、晶片組、繪圖晶片、記憶體、網路微處理器等高階產品。
覆晶封裝技術解析
覆晶封裝流程
封裝業者在接獲完成前段製程工作的晶圓後,採用覆晶封裝技術的製程大致如下:先於晶片上植入金屬凸塊,隨後進行測試、研磨、晶圓切割成晶粒,再將晶粒放置到基板上,以高溫溶化凸塊,並進行填膠、烘烤、雷射標示等流程,之後於基板的另一面植球,再進行清洗、外觀檢查、錫球檢查、最終測試等步驟,待各項流程完畢後,便加以包裝出貨,完成所有覆晶封裝製程。參考(圖二)。
綜觀採用覆晶技術的封裝流程,我們可以發現金屬凸塊、基板、填膠等流程是覆晶封裝過程中的關鍵環節。其中製作覆晶用凸塊的技術包括有印刷、打線成型、電鍍、噴射成型與蒸鍍等,而印刷技術因具備成本低廉、生產彈性的優勢,為目前最主要的製作方式之一,但若以電性(electrical)與線寬(fine-pitch)能力評估,電鍍技術將是未來重要的製程方向。
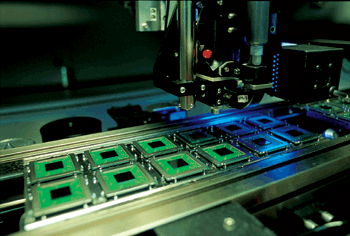
| 《圖二 Flip chip製程之點膠〈資料來源:圖片提供:日月光〉》 |
|
覆晶封裝發展方向
覆晶封裝技術之所以受到重視,主要關鍵在於可滿足新世代電子產品對輕薄短小的高度需求,並能充分發揮晶片應有的效能表現,因此覆晶技術的未來發展方向,也同樣持續受到這兩項因素的趨動,形成了覆晶技術朝向多腳化及薄型化的方向發展。
在腳數方面,目前採覆晶封裝所能達到的I/O腳數約為1600隻(42.5mm×42.5mm),預計至2003年可增加至2500隻(50mm×50mm);而在晶圓的尺寸方面,目前約4mm×4mm,封裝完成後的厚度為1.2mm,並將透過晶粒研磨的方式,朝1.0mm的產品厚度邁進。
一元化覆晶封裝服務之優勢
此外,雖然全球已有多家廠商表示可支援覆晶封裝技術,但在面對此一持續演進的先進技術時,仍存在著許多的製程風險,而如何讓製程中的各環節運作順利,在在考驗著客戶與封裝業者間的互動關係。以日月光為例,除積極強化覆晶技術之外,更整合集團整體資源,提供客戶涵蓋晶圓凸塊、晶圓針測、覆晶組裝、材料供應與後段測試的一元化覆晶解決方案,以單一的服務窗口,縮短與客戶的往返溝通時間,不但提昇服務品質,並以相較其他競爭廠商縮短10至20天的交貨時間,協助客戶降低總體成本,並掌握快速上市的市場競爭利基。參考(圖三)。
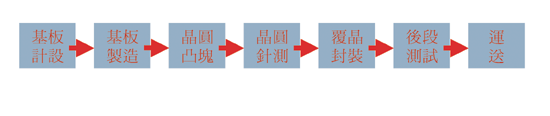
| 《圖三 一元化覆晶封裝服務流程圖〈資料來源:圖片提供:日月光〉》 |
|
結論
毫無疑問的,覆晶封裝技術因具有最短連接長度與最高I/O接點密度,適合應用於電性及散熱效能極佳的高速元件,加上覆晶技術相較於傳統封裝方式面積縮小30﹪至60﹪,可相對提高單位晶圓的產能,因此被視為未來最具潛力的封裝技術,也成為許多封裝業者現階段的研發重心。但在面對廣大的市場需求時,專業封裝服務廠商需尋求突破現階段技術瓶頸的解決方案,致力降低作業成本,並在基板的供應穩定度,以及供應鏈環節的完整串聯等部分持續改進,不但可提昇客戶對覆晶技術應用的信賴感,更使覆晶技術能以最快的發展腳步成為封裝主流。
(本為作者為日月光半導體研發部副總經理)