|
|
| 奈米世代微影技术之原理及应用 |
|
半导体制程演进重要推手──
【作者: 謝忠益、柯富祥】2004年08月04日 星期三
|
|
浏览人次:【94153】
2004年在旧金山举行的Semicon West会议开幕式中,英特尔(Intel)资深研究员暨国际半导体科技蓝图(ITRS)技术策略主任Paolo Gargini指出,半导体的产业发展将会在未来的15到20年继续遵循着摩尔定律(Moore's Law);同时在晶圆尺寸上更会从300 mm增加至450 mm。在此一发展趋势下,微影技术更显示出其重要性。微影(lithography)技术的演进与发展为半导体工业面对奈米时代一个极为重要的推手。
微影技术原理与主流趋势
根据2003年版国际半导体科技蓝图的内容,如(图一),半导体制程会在2004年正式进展到100nm以下,而在2010年进展到50nm以下,因此目前的设备厂商仍在思考那些设备会在50nm以下被使用到。光学微影的曝光光源有汞灯、KrF、ArF(曝光波长为193nm)、F2(曝光波长为157nm)及EUV(曝光波长为13.4nm)等光学微影技术,其分别应用在90nm、65nm及50nm以下。然而,F2技术使用的设备单价在8.5亿台币,而EUV技术使用的设备价格更高达17亿台币,因此到底未来在65nm以下如何能够减少设备太过昂贵的问题以顺利进入量产,目前仍有争论。幸而最近在光学微影设备之技术上有新的创新技术,称为液体中曝光微影术(Liquid immersion lithography;LIL,或称浸润式微影),可以让ArF微影术延伸到65nm,同样的也让F2微影术延伸到32nm,目前全球重量级的研发单位均投入相当多的资源进行研究。
“微影”原意为平板印刷术,微影技术是决定图案定义良窳的重要关键,因此在元件制程中一直被认为是最重要的步骤,如(图二)。光学微影过去数十年一直被广泛的应用在定义图案,而电子束微影则被应用在光罩制作上。未来进入奈米量产制程时,这个组合会被打破。除了光学微影术外,投射式电子束微影及奈米转印微影皆会被使用。本文藉由简介先进微影技术之能力与限制,以期读者能借以了解米世代微影术之发展与其所面临之挑战,首先针对目前颇受重视的浸润式微影技术之原理与应用进行介绍,随后对F2准分子雷射及极紫外光光源微影,做一概略性介绍与讨论。最后则针对电子束投射微影术之演进与设备系统进行介绍,也对于此技术使用的光罩之特性与曝光原理做说明。
微影技术挑战奈米世代制程
光学微影中的两个基本关系式如下:
|
其中为曝光光源波长、NA为曝光系统的数值孔径。为了制作小线宽,势必要将曝光光源波长改为更短的波长,而NA值则是越大越好,但如此一来便会影响聚焦深度,因此,必须在两者间找到最佳值,一般微影技术之相关参数,如(表一)所列。
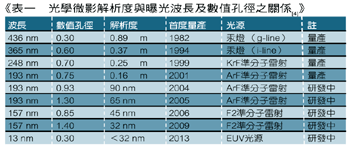
| 《表一 光学微影分辨率与曝光波长及数值孔径之关系》 |
|
元件尺寸微小化的结果,使得现行光学微影的技术益加复杂,甚至于曝出图案的尺寸接近光学绕射极限(diffraction limit)。为达成最佳的元件图案定义,微影术的研究一直不断的进行,主要的方向大致上可以分为三个部分:
- (1)减低曝光的波长,以增光曝光光源的解像能力。从汞灯所发出的g-line(436 nm)光源到深紫外光准分子雷射(193 nm)光源,甚至于下一世代的157 nm与极紫外光光源的开发,皆为了减低曝光的波长;
- (2)增加光学投射系统的数值孔径(Numerical aperture;NA),从早期系统的0.35至0.7,甚至在更先进的光学微影系统会将数值孔径增加至0.8以上;
- (3)利用一些增加解析度的方法以灭小光学系统常数k1,从原本的0.6逼近到0.4。
减少曝光波长可以有效的增加微影的解析能力,但是新光源开发的速度太慢,跟不上元件尺寸缩小的要求。增加数值孔径大幅提升了光学系统设计的复杂度,且大数值孔径会降低聚焦深度(depth of focus)进而增加制程的困难度。而解析度增益技术(resolution enhancement technology,;RET),便成为最主要改善光学微影术的方法。一般在解析度改良技术主要的课题,是在相位移光罩的设计。近年来,有越来越多的研究投入浸润式微影技术之研发,来增加微影技术的解析能力。
备受业界重视的浸润式微影技术
液体中曝光微影的原理早在1980年以前即被应用,只是当时的应用范围主要是在光学检测方面,如光学显微镜及光谱仪等。相较于传统光学量测系统,以液体取代空气作为背景介质,液体介质的折射率高于空气,而可以降低透镜与空气之界面反射,以增加成像的解析度及对比。此一观念亦在1980年代以后转而应用在光学微影系统的研究上[4]。但是在早期的微影研究中并不太重视此一观念,此乃是因为当时曝光的波长(g-line及i-line)小于元件图案的最小线宽,故空气介质的光学系统足以满足制程的需求。再者,由于光学镜片的设计与制作能力的提升,使得数值孔径增加快速而可以符合解析度提升的要求。直到半导制程进步到0.25(m,其对应的曝光波长为248 nm准分子雷射光源;此一世代光学波长小于图案线宽的条件不再,光学微影便出现了第一次的瓶颈,而进入了193 nm曝光波长。而在90 nm则是第二次微影制程的瓶颈,此时下一世代157 nm微影技术尚未成熟,无法再以更短波长光源作为克服制程之法。而在这两次微影制程技术瓶颈时,有学者利用浸润式微影技术以克服传统光学系统的不足。在65nm之下一世代元件制程技术的开发上,使用光学微影术会面临元件尺寸远小于曝光波长之问题,预期浸润式微影技术会益加受到重视。
(图三)为浸润式微影技术系统架构的示意图。光学系统的解像能力与其等效波长(eff成正比,而等效波长与入射光波长的关系为:
其中(0为真空中入射光波长,n为传播介质之折射率。由(公式三)可知,等效波长会随着传播介质的折射率增加而减小,故其光学解像力亦随之提高,此即为其应用在光学显微镜以增加解像力之基本原理。浸润式微影技术亦可从数值孔径的观点来加以解释。数值孔径依介质的不同亦可得其等效数值:
其中(max为光学系统所能传播之最大绕射角度。故利用液体作为光学系统背景介质,可以增加系统数值孔径。而曝光波长的缩小与数值孔俓的增加在此是因为背景折射率的改变,故与真空之微影系统相较,可改善曝光解析能力达n倍。以193 nm光学微影,假设光学系统数值孔径为0.93,k1为0.4,可使用水作为液体介质,其折射率为1.44,则此液体中曝光微影系统之曝光最小线宽,理论上可由原本真空系统的83 nm减少到58 nm。对同一光学微影机台相同解析度要求下,浸润式微影系统不会减低聚焦景深(depth of focus;DOF),反之与干式机台在相同解析度要求下,可以增加聚焦景深达n倍。此一结果亦提高微影制程能力,此技术可应用于高深宽比(aspect ratio)元件之制作。
从65nm到32nm的微影技术挑战
浸润式微影技术相较于传统干式微影术,有高解析度及高聚焦景深的优点,而193 nm浸润式微影机台的开发,可以利用现今技术作一改良,而与目前业界所普遍使用之机台与制程共存,故其被公认为65 nm至45 nm最有潜力之微影技术。而32 nm世代之微影术,则以157 nm浸润式微影技术、极紫外光微影术及投射式电子束微影为最有可能成为主流的技术。利用浸润式微影技术,可以将现今微影制程的极限往下推30~40%。
真空紫外光微影
原在半导体科技蓝图中,65 nm节点的另一候选技术为157 nm微影术,如(图四)。该技术乃是应用F2准分子雷射作为曝光光源,以得到更好的解析度。空气中的水气与氧气对于此一波长范围的光有很强的吸收;故157 nm微影必需要在真空或通入氮气净化的环境下进行。因此称此一波段微影技术为真空紫外光(Vacuum UV)微影术或净化紫外光(Purged-UV)微影术。除了曝光环境的限制外,光学系统(optics)与光阻材料及计上亦与深紫外光(DUV)微影截然不同。该光学系统无法以高纯度熔融玻璃作为材料,而必须使用CaF2晶体;但是该晶体有着固有?折射性(intrinsic anisotropic)之特性,故而要特殊处理。再者,该曝光波长下,大部分材料都有极大的吸收,使得光阻研发亦成为一重要课题。
157nm微影技术门槛使得其成本大为提高,而无法顺利在65 nm制程节点完成世代交替。但是其发展潜力与发展优势在45 nm节点后即可能浮现。利用157 nm干涉式液体中曝光已经可以实际曝出最小线宽约为30 nm之光阻图形,如(图五)所示。 157 nm浸润式微影技术更可能成为32 nm节点量产的首选微影技术。
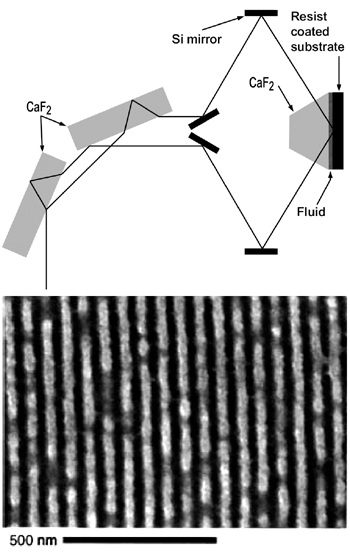
| 《图五 157nm干涉式液体中曝光之实验架构图与曝光后所得之光阻图形》 |
|
而在32nm节点之后之微影制程在目前看来,需要应用非传统光学投射式微影技术;而目前最有可能成为该世代之主流微影之可能技术有二:一为极紫外光微影( Extreme UV lithography;EUVL),另一则为电子投射式微影术(electron beam proximity lithography;EPL)。
极紫外光微影
极紫外光微影术乃是应用极紫外光光源,其波长为13~14 nm,如(图六)。由公式一之解析度公式可以看出,应用极紫外光光源可以有效地增加微影系统的解析能力。但是在此一波段下材料之光学性质与一般可见光波段之光学性质炯然不同,故该系统从光源、光学系统、光罩乃至于光阻材料上皆在研发阶段。极紫外光之光源是利用电浆放电时所产生之射线,主流有二:一者为雷射激发电浆方式,另一则是利用电子激发电浆放射出极紫外光,如(图七);而这两种光源的效率及使用寿命与量产要求相比,尚有进步之空间。

| 《图七 极紫外光微影(a)光源与(b)光罩之示意图》 |
|
一般来说,光源的强度希望能在120W,而其放射频率可达到4000 Hz,以达到产量为100 wph;光源击发次数可以超过108次。而光源使用几乎所有材料在极紫外光波段都有很强的吸收,故传统微影折射式光学系统与光罩已经无法再使用,而必须改成全反射式。就光学呈像系统而言,反射式系统有着较小数值孔径及较大像差之缺点,所以在传统光学微影系统的设计上尽可能避免,而157 nm微影亦是使用CaF2折射式光学。而光罩则需使用多重镀膜的方式,以增加其反射率;而先进光罩所使用之相位移材料(phase-shifter)亦尚在研发之阶段。虽然看起来此一技术所需之时间与成本相当高,但是在2013年后之次32 nm世代,其问题的解决与成本的降低都存有不小的希望。
电子束微影
电子束微影术早在1960~1970年代就被发展,如(图八)所示。最初的Gaussian beam技术是每次射击(shot)只有单一电子(pixel),虽然解析度相当好,但是因为曝光速度太慢,因此较不具量产可行性。图上指出在1970~1990年代分别有Fixed shaped beam、Variable shaped beam及Cell shaped beam等技术被发展出,其平均的曝光速度比Gaussian beam技术快上1000倍。但是由于其曝光速度仍然很慢(约每小时2片),因此仅做为光罩直写的量产使用,仍然无法用在晶圆的量产。
1981年,IBM公司的Pfeiffer博士提出可变轴透镜技术(Variable Axis Immersion Lenses;VAIL),随后此技术经过改进后,到了1995年[17]发表具晶圆量产可行性的电子束技术,称为投射微缩可变轴透镜曝光技术(Projection Reduction Exposure with Variable Axis Immersion Lenses;PREVAIL)。此技术的优点是系统透镜组会移动,因此电子束之中心轴会移动,可以将电子束进行移动曝光,具有局部快速扫瞄的特性。此技术属于电子束投射微影术之一种,经IBM公司研发后并与Nikon公司进行设备生产合作,今年已经有(型式机台展示。
另外一种电子束投射微影术系由Bell实验室在1990年发明[18],称为限角散射电子束投射微影术(Scattering with Angular Limitation Projection Electron Lithography;SCALPEL),此技术与PREVAIL技术皆需要光罩,其成像皆会缩小四倍。 PREVAIL与SCALPEL这两种电子束微影术其每次射击有107电子[15],且其在晶圆上的成像线幅会比其使用之光罩线幅缩小四倍,故此技术已经成功克服曝光速度不够快的缺点,未来可以应用在晶圆量产上,对于8吋的晶圆每小时可曝到25片。
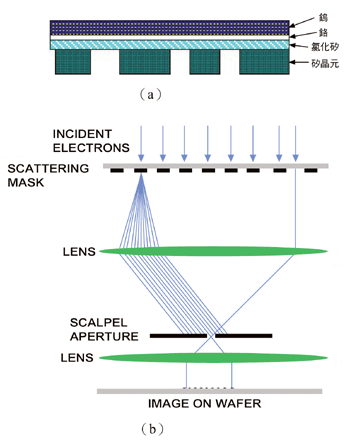
| 《图九 SCALPEL(a)光罩与(b)其电子束曝光系统图》 |
|
(图九)所示为SCALPEL的原理,入射电子束经过光罩后的散射有两种模式,其一是经由光罩上金属层所导致的大角度散射电子,此电子会在开孔处( Aperture)被吸收掉,因此无法到达晶圆表面之阻剂。另外则是经由光罩上介电层所导致的小角度散射电子,这部份电子经由电磁透镜聚集及缩小四倍边长后,会导到晶圆表面之阻剂层,形成阻剂之化学反应。上面两种散射对比,即为SCALPEL之成像原理。
SCALPEL使用的光罩是有两层,其中一层是用150nm之Si3N4所做成的薄膜,由于其原子序较低,因此电子束经过此膜后会有小角度的散射。另外具有图案之一层是由原子序较大的金属(例如W)所组成,当电子束通过此金属时会被大角度散射掉,而通过无金属部份的电子束最后会被成像。
至于PREVAIL之成像原理,则如(图十)(a)所示。电子束经过篓空(stencil)的光罩,可以被电磁透镜聚集及缩小四倍边长后,会导到晶圆表面之阻剂层,形成阻剂之化学反应。但是电子束经过有图案的Si膜则会被散射,然后在开孔处(Aperture)被吸收掉。上面两种散射对比,即为PREVAIL之成像原理。
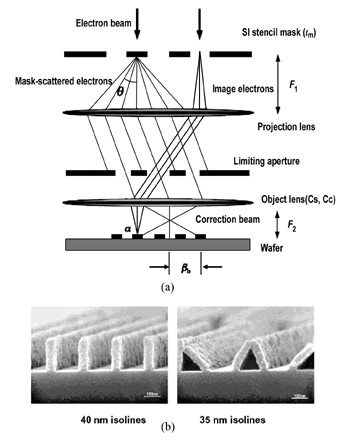
| 《图十 PREVAIL(a)电子束曝光系统图及(b)所曝得之光阻图形。》 |
|
PREVAIL使用的光罩是由较厚的Si层所组成,其厚度约1~2(m,然后在Si上形成篓空图案。虽然使用的电子束散射材料是原子序较低的Si膜,但是由于其厚度达到(m级,因此其电子束会有较大的前向散射(Forward scattering),达成图案对比。(图十)(b)所示为此技术在负型化学放大阻剂层( 200nm)之成像[20],使用100kV加速电位,在15.5(C/cm2的剂量下可以得到40nm的图案,此外35nm的线亦可以曝出,但是阻剂与基材的接着力不佳而有部份图案倾倒。
根据(图十一)对65nm世代微影技术的预测,EPL技术对于中量(middle volume)产品(250~2500片晶圆/光罩)具有最低的微影成本。而电子束直写技术(EBDW)因为不需要制作光罩,对于低量(small volume)产品(<250片晶圆)具有最低的微影成本。至于对于高量(high volume)产品(>2500片晶圆/光罩),则仍然以使用光学微影术(例如LIL或EUV)具有最低的成本。但在32nm以后之世代使用的微影术,目前仍未有较一致的看法。
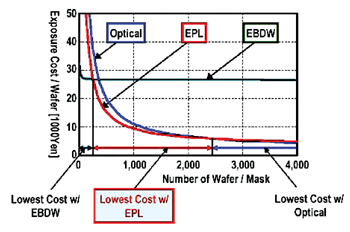
| 《图十一 65奈米世代之微影成本与晶圆数之关系图》 |
|
结语
国内半导体发展已在世界上占有十分重要之地位;就微影技术来看,我国目前在晶片制造方面是极为重要的。故微影相关技术在发展的过程,台湾不再只是一个纯粹的使用者,而更参与并影响着微影技术的选择与方向。随着半导体的摩尔定律的预测,微影技术奈米世代的挑戢益加复杂。反观过去由紫外光进步至深紫外光,在未来更会延伸至真空紫外光乃至于极紫外光微影,或是先进电子束曝光技术;纵使技术难度越来越高,但是微影技术的突破与进步可预期地会在往后的15至20年持续地提升半导体制程及复杂度,使得电子产品的设计与应用在更长远发展,有着稳固之基石。 (作者任职于国家奈米元件实验室)
|

