Intel在去年十月发表了新的封装技术-BBUL(Bumpless Build Up Layer),并宣称这项新技术将有助于20GHz晶片时脉的微处理器在2006或2007年前上市。
BBUL,顾名思义,此技术并无使用凸块(Bump)的制程,而是利用多层板增层技术连接IC与基板(Substrate)。由于减少了凸块的高度,BBUL封装后产品的高度只有1mm,不到一个硬币厚度,非常符合未来产品走向轻、薄、短、小的趋势 (图一)。不过,Intel宣称这项新技术仍在实验开发的阶段,在2006或2007年前并无量产上市的计划,由此可以想见其制程及成本上仍有相当的问题尚待解决。

| 《图一 BBUL封后的厚度比硬币的还薄》 | 数据源:Source: Intel Labs |
|
虽然如此,BBUL技术的提出,仍引起产业界不少的讨论;特别是当多数人已将覆晶(Flip Chip)技术视为未来高阶封装的必然趋势时,Intel却又另辟蹊径前进,并将凸块专工大厂的角色功能弃之不顾。可以想见,BBUL一出势必将对产业链的布局又多添变数。
目前Intel的最新处理器Pentium4,内含42百万位电晶体数,其封装制程是采用覆晶(Flip Chip BGA)以锡铅凸块连接晶片。这种封装方式仍需要中间层或高密度的基板,它的相对位置是介于凸块与Pin之间。相反地,BBUL则是「晶片优先」(Chip First),将晶片内嵌于最中央的位置,这点与覆晶技术将晶片放在最上面有所不同。
制程介绍
BBUL的制程,首先是在基板上方以冲压的动作挖出可供晶片嵌入的区块,并于基板下方加上一层薄膜(Tape),之后将晶片置于区块内并灌胶,紧接着进行烘烤,之后再去除薄膜。薄膜在此可提供晶片与其四周一个平坦界面。而邻近于晶片的基板区则可提供一个平台,方便下面的溅镀及显影制程进行。换句话说,如果晶片是面朝上的(Face Up),邻近区块的高度将很难掌控,也连带影响晶片与其之间的水平高度。所以,有薄膜提供一个共平面的平台再加上晶片面朝下(Face Down)的放置,晶片与周围高度恐不相同的顾虑即可解决。
增层动作
基板的平坦界面制作完成后,接着便要进行增层(Laminate Layer)动作:首先铺上一层绝缘层(Dielectric Layer),再以雷射钻孔为下一段重布铜制程金属互连层(Copper Interconnect Layer)做准备,金属层的沉积是以溅镀(Sputtering)方式进行,并以曝光显影技术将线路显现于金属层上,然后进行电镀并蚀刻出线路,最后进行一般的表面黏着(SMT)制程。
这里的增层动作与晶圆级封装(Wafer Level Package)制程非常类似,只差晶圆级封装是于晶圆上进行,BBUL则是在单一晶片上进行。当然,也可于面板(Panel)层次上进行增层,只是在光罩曝光显影方面,无法像WLP上一片即可,而是采逐次曝光(Step-N-Repeat)的方式,对每颗晶片逐一曝光。不过,BBUL与晶圆级封装最大的差异点即在于,BBUL可将线路往外设计,即所谓的Fan-Out,但WLP的线路只能在晶片区域内设计,即所谓的Fan-In。所以当晶片的面积不断缩小(Die Shrinking)时,只能Fan-In的封装,I/O接脚数目想必受到抑制,因此只适合做低I/O数的产品。
一般基板的增层法(Build Up)是于核心层(Core Layer)的顶部及底部增层,也就是所谓的Build-Up Layers。有趣的是,BBUL的结构,则把晶片内嵌于基板的区域作为核心层,之后仅需往上增层即可进行讯号传输(图二)。与覆晶比较,BBUL可避免凸块和底胶(Underfill)所衍生的问题。
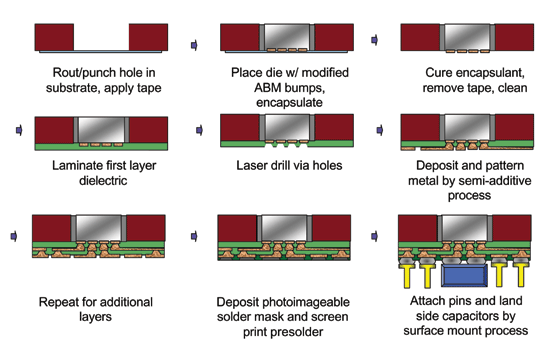
| 《图二 BBUL以芯片内嵌于基板内的区域作为核心层》 | 数据源:Source: Intel Labs |
|
BBUL的优势在于讯号由晶片走到主机板的距离更加缩短了,因此讯号传递将较为完整。而随着半导体制程的精进,每单位电晶体的体积愈来愈小,IC体积也得以减少,此外随着IC功态愈趋复杂及电晶体数目的成长,接脚数也必须增加,这些因素都使得pad间的间距(Pitch)值必须减小。
传统覆晶C4制程,由于受限凸块的尺寸,pitch值缩小的弹性有限。而BBUL是以「增层」概念封装,无凸块限制,pad 与pad间的pitch变小(约140μm),较能承载目前及日后对短时间即能处理大量讯号的封装需求。 (表一)
表一 BBUL与Organic差异比较
Next generation
Technology
Capabilities |
Organic
(FCPGA-type) |
BBUL |
| Die-package pitch |
180μm |
140μm |
Package
Line/Space
dimension |
25μm/25μm |
25μm/25μm |
Package inductance
for land-side
capacitors |
1.3pH |
0.1pH |
Source: Intel Labs

