西门子数位化工业软体与矽品精密工业(矽品;SPIL)合作,针对 SPIL 扇出系列的先进(IC)封装技术,开发和实作新的工作流程,以进行 IC 封装组装规划与 3D LVS(layout vs. Schematic)组装验证。此流程将被运用於 SPIL 的 2.5D 和扇出封装系列。
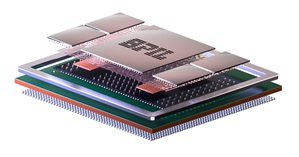 |
| 西门子与SPIL携手为扇出型晶圆级封装提供3D验证工作流程 |
为了满足全球市场对於高效能、低功耗、小尺寸 IC 的上涨需求,IC 设计中的封装技术也变得日益复杂,2.5D 和 3D 配置等技术因应这种挑战而出现。这些技术将一个或多个不同功能的 IC 与较高的 I/O 和电路密度相结合,因此必须能建立和检视多个组装和 LVS、连线关系、几何形状与元件间距情境。为了帮助客户轻松部署这些封装技术,SPIL 选用西门子的 Xpedition Substrate Integrator 软体与 Calibre 3DSTACK 软体,用於其先进扇出系列封装技术的封装规划及 3D LVS 封装组装验证。
矽品精密工业股份有限公司研发中心??总王愉博博士表示:「矽品所面对的挑战是要开发和部署一个经过验证且包括全面的 3D LVS 的工作流程,来进行先进封装组装规划和验证。西门子是该领域公认的领导厂商,拥有稳健的技术能力并获得市场的认可。矽品将在今後的生产中使用与西门子共同打造的流程来验证我们的扇出系列技术。」
SPIL 的扇出封装系列能够提供更大的空间,方便在半导体区域顶部进行更多 I/O 布线,并经由扇出制程扩大封装的尺寸,而传统的封装技术无法做到这一点。
西门子数位化工业软体电路板系统高级??总裁 AJ Incorvaia 表示:「西门子很高兴与 SPIL 携手合作,为其先进封装技术定义和提供必要的工作流程和技术。随着 SPIL 的客户继续开发复杂性更高的设计,SPIL 与西门子也随时准备好为其提供所需的先进工作流程,将这些复杂设计快速推向市场。」

