SiGe:C npn电晶体异质接面双极性晶体管(HBT)是BiCMOS IC 中针对高速类比和混合讯号应用的核心技术,它具有以下特性︰基极中少数固有电子高度的机动性、SiGe:C能使偏移所提供的附加性能增强,以及利用硼轻松取得清晰的p型外形。
另一方面,高速互补(npn与pnp电晶体)技术(CBiCMOS)要求pnp与npn HBT具有相似的性能。先对SiGe pnp基极外形中所做的平衡措施进行识别[1],以免造成少数载波的传输性能下降。但由于常见掺杂质(如磷和砷)在较大程度上分离的状况,n型SiGe基极掺杂工程技术目前仍是一项挑战。
针对此挑战,因此提出了使用标准和原子层掺杂(ALD)技术的掺杂工程技术概论,并显示了与硼对等的掺杂外形可透过使用ALD的砷和磷来取得。
实验
SiGe︰C 磊晶
减压化学气相沉积技术(RPCVD)使用于SOI图案基版上沉积SiGe:C薄膜。 SiH4、GeH4和甲基矽甲烷气体分别用于矽、锗和碳。 AsH3和PH3是杂性气体,通常,氢气和氮气中的沉积压力均为 40Torr。
增长顺序为︰在一个矽缓冲薄膜层上覆盖约25奈米浓度倾斜的SiGe:C层(锗莫尔定律为0至16%)、约30奈米浓度的SiGe:C基极层,以及一个会在600℃时增加的浓度为0.2%的碳层。杂质透过共同沉积(标准型)或ALD覆盖杂区、20奈米浓度的SiGe隔离薄膜层(无杂质)导入基极中,最后在 650℃的氢气中沉积矽保护层。
在ALD制程中,增长过程会受到中断,气体转化为氮气,而且表面也会暴露在PH3或AsH3中。可以对暴露的时间和温度进行调整,以获取所需的杂质量。 SiGe:C隔离层会在氮气中继续增长。可调整SiH4/GeH4莫尔比例以保持平整的锗外形。 SIMS用来确定SiGe:C和杂质的外形。
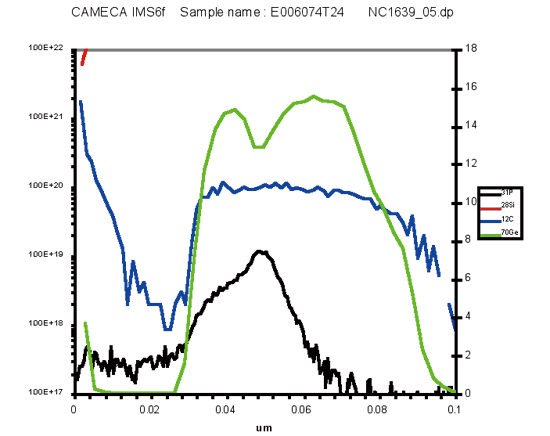
| 《图一 磷掺杂在550℃氮气中增长的SIMS外形》 |
|
标准掺杂
在550℃的氢气中使用PH3进行标准掺杂,会形成约20nm/dec的较大陡度磷外形,而降低SiGe:C隔离层的增长温度也不实际,因为氢气表面钝化会大幅降低成长率和合成率。
然而根据业界研究指出[2],当温度较低时,氮气中的SiGe外延会比氢气中的成长率高。在类似的增长温度下会出现更大程度的磷合成和更清晰的峰值浓度,如(图一)。然而,陡度也会对后掺杂过程带来负面影响,并产生相似长度的过渡时间。此外,如果在杂制程结束后继续增长,则GeH4会受到很大抑制,这是第一次发现GeH4抑制。
在杂过程中提升SiH4/GeH4莫尔分率会降低抑制水准,然而,一般认为该过程无法顺利进行。在基极外型中添加其他势垒会对厄利电压和截止频率产生很大影响。 Murota早先发现氢气中添加的SiGe中的PH3将会导致SiH4抑制[3]。在氮气中,由于缺少氢气,可能会导致GeH4与SiH4对比出现更大的抑制。
由于砷杂具有更低的扩散率,所以与磷相比它具有更大的优势。然而,沉积过程会在图案基片上进行,导致基极窗口单晶 epi 中的最小杂质合成,同时大多数的砷也会被合成至多晶矽层中。而化学加载效应是砷优先移植的原因所在。

| 《图二 在500℃氮气中增长的SiGe:C隔离层的磷ALD的SIMS外形》 |
|
ALD原子层掺杂
Tillack et al[4] 深入研究了硼和磷的ALD制程,在所用的方法中,暴露时间和温度分别设置为60秒和550℃,以取得中间的E19/cm3峰值浓度。 SiGe:C隔离层会在600至500℃的在温度范围内增长,以监控隔离效应。温度高于550℃时,陡度会增至36nm/dec;温度降至500℃时,陡度则为6nm/dec;(图三)显示了具有分别在500℃和650℃时增长的SiGe隔离层和矽保护层的ALD制程的基极外形,以及三个只在制程吞吐率方面略有下降的连续进程的制程再现性。
除碳之外,砷的 ALD 会以与磷相同的形式执行;(图四)显示了双层上的SIMS外形,其中SiGe隔离层的增长温度为530至500℃。不同于标准掺杂的是,砷的ALD会导致基极窗口中进行更大程度的砷合成,这些窗口具有约4E19/cm3的峰值浓度以及多晶矽面中更高的合成率,另一方面也证实了标准掺杂过程中的化学加载效应。砷外形的陡度与磷相似,同时也注意到SiGe隔离层中轻微的SiH4抑制和表面上大量累积的砷。
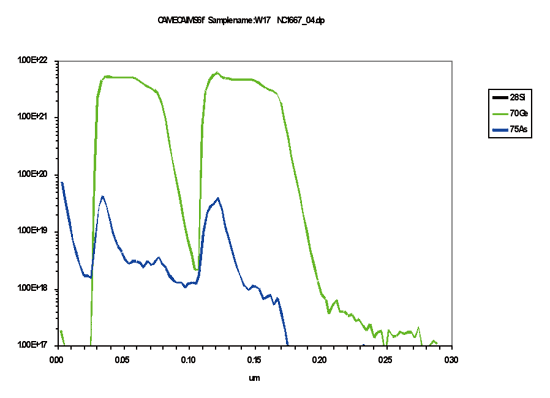
| 《图三 在500℃和530℃氮气中增长的SiGe隔离层的砷ALD的SIMS外形》 |
|
结论
标准和ALD掺杂制程可优化SiGe基极层中的n型掺杂外形,ALD显示了陡度范围在6nm/dec以内的磷和砷的最佳剖面图,以下将于这些剖面图中提供后发射布植退火效应的对比结果,以及DC和RF性能。
---本文作者皆任职于NS美国国家半导体---
<参考资料︰
[1] G. Zhang, J.D. Cressler, G. Niu, A. Pinto, Solid-Sate Electronics, 44, 1949-1956 (2000) ;
[2] P.Meunier-Beillard, M. Caymax, K.Van Nieuwenhuysen, G. Boumen. B. Brijs, M. Hopstaken, L. Greenen, W. Vandervorst , Applied Surface Science, 224, 31-35 (2004) ;
[3] J. Murota, M. Sakuraba, B. Tillack, Mat. Res. Soc. Symp. Proc. Vol. 809, (2004);
[4] B. Tillack, Y. Yamamoto, D. Bolze, B. Heneman, H. Ruker, D. Knoll, D. Wolansky. J. Murota, W. Mehr, , Extended Abstracts of the 2005 International SiGe Technology and Device Meeting, p. 25J-2。 >

