KLA-Tencor推出了最新一代的PROLITH虛擬黃光電腦模擬軟體PROLITH X3.1。其讓晶片廠商、研發機構及設備製造商能夠迅速且具成本效益地解決超紫外線(EUV)和雙次成像微影(DPL)製程中的挑戰,包括與晶圓堆疊不平坦有關的邊緣粗糙度(LER)和成像問題。PROLITH X3.1微影模擬軟體能夠簡化他們的研發,節省微影單位資源,並加速產品的開發。
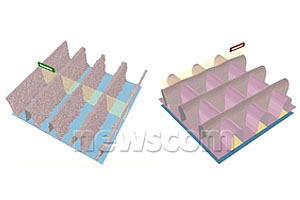 |
| KLA-Tencor推出PROLITH X3.1虛擬黃光電腦模擬軟體。 |
KLA-Tencor製程控制資訊部副總裁兼區域總經理Ed Charrier表示,在評估2Xnm及未來更先進設計的多項微影技術方面,研發人員必須了解製程設計前後如何影響在晶圓上的成像,包括光罩設計、掃描曝光機設定、晶圓堆疊不平坦和光阻成份的差異等影響。PROLITH X3.1並不實際曝光測試晶圓,而是模擬成像結果,利用基本物理學原理來協助研發人員研究和最佳化微影製程。新的X3.1版EUV和LER功能只需數分鐘就能產生精準結果,使其可以大幅縮短產品開發時間。此外,這項策略還能降低掃描曝光機、track和CD-SEM機台轉至運行可行性實驗的時間,釋出EUV技術以便進行整合與測試,或釋出微影技術以增加生產運行。
PROLITH X3.1其設計目的是讓研發人員能夠經濟高效地研究不同的微影技術,相關功能:
.市場上第一款考慮光的量子行為和光阻中的離散反應分子的隨機型(或然率)品,能夠協助研發人員;
.數分鐘的運行時間精準模擬 LER,讓在實際的晶圓廠中研究各種製程條件對LER的影響成為現實;
.影像刻印的可重複性以及對良率的影響進行研究;
.線和接觸孔CD的均勻性進行預測;
.判定可用的製程容許量;
.測試不同的光阻反應物載入級別如何影響成像(例如製程容許量、CD控制、缺陷級別),從而讓材料製造商能夠以顯著降低的成本探索光阻配方;
.第一款模擬EUV光電子微影製程結果的產品;
.直覺的晶圓堆疊不平坦設定和改善後的晶圓堆疊不平坦模組允許迅速、方便地對雙次和單次成像非平坦微影層積和諸如FinFET等次世代非平坦元件進行評估;
.超過60個高精準度、經過校準的光阻模型,可供立即使用;
.在一台32位元個人電腦上執行的直觀介面能夠提供迅速、精準的微影模組,無需升級電腦或使用超級電腦;
.可以升級PROLITH平台,提供擴展能力,保護研發人員的現有投資。