近期看到FPGA大厂陆续推出3D系统芯片,令人想起几前年半导体产业开始积极推展的3D芯片,似乎经过几年的酝酿,目前开始看到该技术的开花结果。只不过,Altera台湾区总经理陈英仁指出,这些其实都是属于2.5D的制程,不是真正3D的技术范畴。3D制程的技术含量更深,目前仍是个很大的挑战。
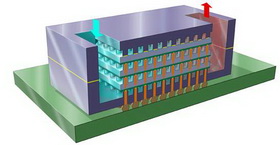 |
| 3D芯片要真正商用化,现在仍太早。 |
陈英仁说,目前FPGA大厂所标榜的3D芯片,其实都只是2.5D制程技术,并非真正的3D芯片。目前2.5D技术逐渐成熟,产品也陆续推出市场。然而,从2.5D到3D,这看似短短一步可及的距离,事实上其技术难度却有如天与地一般遥远。
2.5D芯片的采用,其实正是3D真正商用化之前的一种替代方案。2.5D芯片其实就是将主动组件放在被动的硅中介层上。硅中介层能平行连接数个硅切片,透过和PCB上不同的IC金属互连方式,这些硅片能经由该中介层的金属互连来连接。
3D芯片经过几年的发展,尽管已经克服许多困难,但3D芯片要真正商用化,坦白说现在仍太早。3D芯片等同于整体芯片设计的革命性突破,这包括从基础IC设计、芯片封装到散热机构等细节。
3D芯片最大的挑战,最先面临的就是芯片的连接方式。目前最可行的TSV,是在数个垂直堆栈的芯片上穿孔来连接芯片,但技术尚未成熟,成本也高,良率相对偏低。其次是散热。当多个主动式芯片堆栈在一起时,每个芯片运作所散发的热要如何排出就是个大问题。特别是当芯片堆栈在一起时,中间部份几乎无法散热。曾有工程师提出3D芯片中,透过风孔排热的构想,但难以实现。散热问题不解决,3D芯片便很难跨出下一步。
此外,TSV的穿孔,也会在芯片发热时产生大问题。芯片遇热膨胀后,应力会影响外围的晶体管性能,这是TSV发展过程中最难解决的部分。专家认为,3D芯片要走到成熟的阶段,估计还要至少3年以上。看来,这短短0.5D的路,半导体产业还得走上很久。