2008年全球半导体产业在渡过了冷清的第一季之后,原本预期将会逐渐回温的第二季景气,也在全球通膨与美次贷危机的夹击下,造成消费者信心大幅衰退,预料成果也不会太好看。在第一、二季相继失利且短期不见回升信号之后,市场研究机构已把景气拉回的时间点放至2009年之后,然而,景气回升的时间越晚,对台湾的半导体业者的影响便越大,尤其是晶圆代工相关产业,因为在产量渐增,产值和售价却未相对增加的情况下,提高附加价值是重要课题。因此,及早投入并开创出另一个高附加价值的新业务是非常必要,而3D芯片便是台湾晶圆代工产业最值得投入市场。
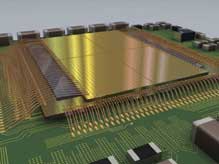 |
| /news/2008/07/21/0043061223.jpg |
根据国际半导体设备材料产业协会(SEMI)的硅晶圆市场分析报告显示,2008年第一季半导体晶圆出货较2007年第四季减少1%,而出货面积则增加3%。SEMI指出2008年第一季晶圆的出货,符合整体半导体产业的情况,其中12吋晶圆的出货则持续增加。另一家投资研究公司Friedman Billings Ramsey 则预期,2008年晶圆市场的产值将缩减5%,FBR估计,2008年第一季8吋晶圆的价位下跌3%~5%,12吋晶圆下跌2%~4%。整体言而言,2008年第一季的平均售价比2007年第四季下跌2%~3%。
因应此趋势,台积电及联电已决定在2008年大减资本支出,主要的原因便是希望减少晶圆代工市场产能供给过剩压力,并减缓晶圆平均出货价格的下跌压力。但摩根士丹利却指出,由于总体经济环境的衰退,晶圆代工厂减少资本支出,对提升平均价格并没有实质。因为过去几年晶圆代工价格滑落原因,并不完全都是导因于供给过剩,就算供给吃紧,业者也无法提高价格,而降低资本支出,不断加重的研发费用仍会对获利造成冲击。
目前台湾的晶圆代工厂在先进制程皆加大资金投入,但由于景气衰退客户采用先进制程芯片的速度已放慢,所以晶圆代工厂的竞争更为激烈,价格也有很大的跌价压力,有时90奈米及65奈米的毛利率,反而不如其他的成熟制程。
为了避免走入制程压力并提高附加价值,台湾发展3D芯片生产也许是条可行之路。所谓3D芯片是指与成千上万个垂直连接点连接的芯片,也就是利用「堆栈」方式生产芯片的技术。目前大部分的晶圆厂在3D芯片生产仍在开发阶段,产量仍不高,但至2009年时,产量便会出现突破性的成长。市场研究公司Yole Développment预测,到2012 年,3D芯片的晶圆的年复合成长率将超过60%。
过去堆栈式封装通常用在移动电话和其它小型的装置上,透过将SRAM、闪存和DRAM堆栈在一起并用导线接合。或者把微控制器与内存相连,继而成为所谓的SiP系统级封装解决方案。目前业界已将3D作为减少内存和逻辑电路延迟的一种方法,或者作为将一种非标准制程制造的芯片连接到一个CMOS芯片的方法。现在的3D芯片已朝向立体堆栈的型态,以达到缩减体积、降低能耗、及增进效率的多方面益处。现今主要3D芯片的产品多为RF、CIS、内存、MEMS等为主。
应用在3D芯片的技术中,采用Via first方式是以TSV的技术形成Via,则需要用半导体前段的蚀刻制程来完成,因此,台湾的晶圆代工业者便可利用既有的设备和技术,来扩建一家从TSV到Bonding制程能力的公司,或者与专业封装厂来进行分工。由于3D 芯片技术属于晶圆制造的层级,晶圆代工厂具有晶圆制程的技术,跨入3D 芯片技术具有一定的优势。
目前台湾的晶圆制造和封装皆是世界第一,对于发展3D芯片更有绝佳的优势,只要政府与产业能够妥善合作,相信一定能有所作为。



